利用低温低频噪声分析六方氮化硼石墨烯超晶格?
利用低温低频噪声分析六方氮化硼石墨烯超晶格结构
X. Li, et al [3]通过外延生长制备石墨烯/h-BN异质结构,这种新型超晶格结构提供了同时观察Dirac点(DP)和 Satellite Dirac 点(SDP)的机会。作者对于器件的 1/f 噪声特性做了一系列测量和分析,得到了原本只能通过扫描隧道显微镜或低温磁输运测试才能获得的推论。
作者在 300K 对 4 个基于 h-BN 异质结构的石墨烯场效应管做测量,测得其电阻随背栅电压Vbg 的变化,如图3-1(a-d);测得在100Hz处的归一化噪声功率谱密度 Sid/Id2 随 Vbg 的变化,如图3-1(e-h)。1/f 噪声谱上的3个局部小值点,分别对应 2 个SDP 点和 1 个 DP 点,与电阻测量的结果一致。对于所有器件,1/f 噪声在 Vbg=-5V 附近处有一个局部低点,对应 DP 点;其它两个极小值点对应 SDP 点。
在 SDP 处,电子和空穴同时贡献噪声,残留电荷对于陷阱电荷提供有效的屏蔽。当栅压远离从负向远离SDP时,空穴强于电子,电子引起的噪声增量将多于空穴引起的噪声减少;当栅压从正向远离 SDP 时,电子强于空穴,空穴引起的噪声增量多于电子引起的噪声减少;因此在SDP处会观测到一个噪声极小值。在 SDP 附近,噪声极值点的表现,要比电阻的表现显著得多。实验中4个器件在 SDP 附近表现出类似的IV特性,但噪声特性有显著差异。
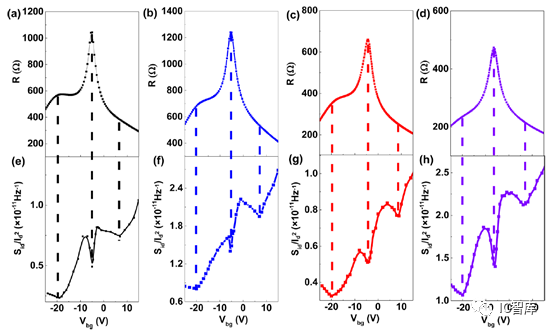
图3-1.(a-d)Resistance versus applied gate voltage (Vbg) for four different graphene/h-BNsamples at room temperature, Vd=50mV. (e-h) Current spectral density Sid/Id2at f = 100 Hz versus back gate voltage Vbg for the corresponding FETs. The dotted lines show that the resistance peaks in panels a-d coincide with the(Sid/Id2) min in the panels e-h.
作者进一步研究噪声功率谱与电流的关系,如图3-2,注意到左右 SDP 处噪声的不对称性相对于电流显著得多。在这种超晶格中观测到的非对称的噪声现象,不能用传统的噪声模型解释。因为例如 Hooge 模型和 McWorther 模型等经典模型,噪声均依赖于载流子数或迁移率波动。而在这里电流接近但噪声不同,噪声的非对称性应该与一种电子-空穴的对称性破缺有关,它源自邻近层间耦合,并且这种机制与载流子数或迁移率波动相比有很显著的影响。
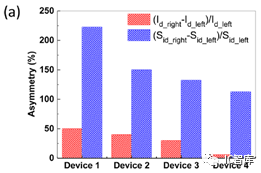
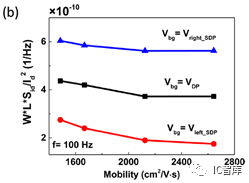
图3-2.(a)Asymmetry in drain current (red) and noise level (blue) at the two SDPs forfour different devices at room temperature. (b) Area normalized noise spectral density as a function of mobility at the DP and two SDPs.
作者进一步对比同一个器件在 300K 和 4.3K 的温度条件下,不同 Vbg 条件下测得电阻(Vd=50mV)和归一化噪声功率谱密度(f=100Hz),如图3-3。在低温下,SDP 仍然对应噪声极小值点。对于 DP 点,噪声随栅压变化,在常温下表现为M型,而在低温下转变为Λ型。这可以解释为,由于低温下活跃陷阱冻结而电子能够更好地屏蔽电势波动,使得噪声形态从M型变为Λ型;但 SDP 点处 V 型的噪声形态不随温度变化,说明电子屏蔽效应在此处不明显,而 SDP 能级处也没有很多活跃陷阱。
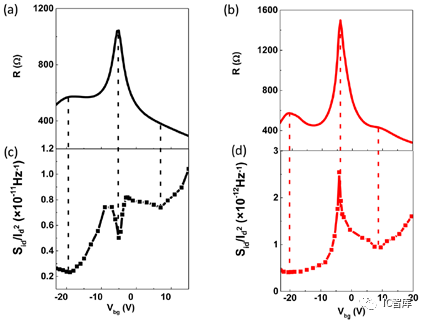
图3-3.(a-b)Resistance versus applied gate voltage (Vbg) for device 1 at 300 and 4.3K. (c-d) Current spectral density Sid/Id2 at f=100 Hz versus back gate voltage Vbg for the same device at the corresponding temperature.
作者引入的低频噪声测试,作为非破坏性的手段,能够用于确定石墨烯/h-BN 异质结构场效应管的DP、SDP,并进一步协助分析结构机理,获得之前只能通过扫描隧道显微镜电镜或低温磁输运测试才能获得的结论。








